 機械金属部
機械金属部表面分析は、電子、イオン、電磁波などを固体に照射して、表面から発生する様々な情報を解析することによって行われています。下図は、各プローブによる様々な情報の関係、分析方法の関係を模式図で示したもので、発生する情報の広がりは、用いたプローブと検出因子によって決定されます。このため、深さ方向、横側の解像度は、装置によって異なります。
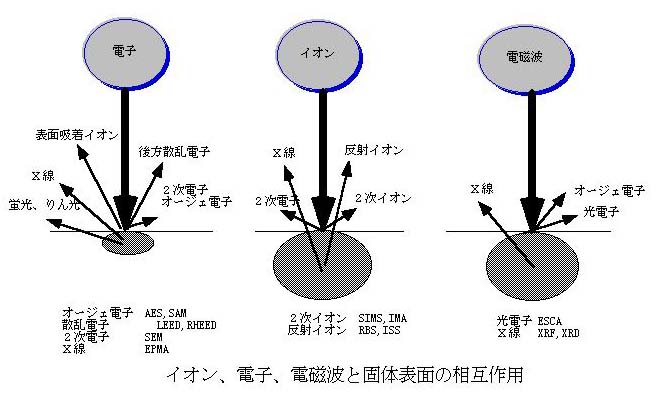
走査型電子顕微鏡(SEM) 透化型電子顕微鏡(TEM),分析電子顕微鏡(AEM) X線マイクロアナリシス(EPMA) オージェ電子分光法(AES)、走査型オージェ電子顕微鏡(SAM) 低速電子回折法(LEED) 高速反射電子回折法(RHEED) 電子エネルギー損失分光(EELS) 出現電圧スペクトル(APS) 組成:AES,EPMA,AEM
原子配列:LEED,RHEED
深さ分析:AES
表面形態:SEM
粒子線励起X線分析法(PIXE) イオン励起発光分析法(SCANIIR) 二次イオン質量分析法(SIMS) イオン散乱分析法(ISS) ラザフォード後方散乱分析法(RBS) グロー放電発光分析法(GDS) 組成:ISS,SIMS,PIXE,RBS
深さ分析:SIMS,SCANIIR
電子状態:PIXE
フーリエ変換赤外分析法(FT-IR) ラマン分析法(Raman) レーザマイクロプローブ質量分析法(LAMMA) X線光電子分光法(ESCA,XPS) X線回折法(XRD) 蛍光X線分析法(XRF) 組成:XRF,ESCA
化合物:FT-IR,Ramman,LAMMA,LMA,XRD
化学状態:ESCA,UPS
深さ分析:ESCA
last updated 26th Feb. 1998
Tsutomu Morikawa
Technology Research Institute of Osaka Prefecture